BGA 보이드와 X-Ray 판정 가이드: 언제 허용되고, 언제 리워크를 검토해야 할까
BGA 보이드는 무조건 불량이 아닙니다. 중요한 것은 void 크기 자체보다 위치, 분포, 전력 밀도, 열 경로, 고객 승인 기준입니다. 이 글은 BGA assembly 현장에서 X-ray로 무엇을 보고 어떤 조건에서 리워크와 공정 수정이 필요한지 실무 관점에서 정리합니다.
Hommer Zhao
· 창립자 & 기술 전문가

BGA 조립에서 보이드는 가장 자주 과잉 반응이 나오는 주제 중 하나입니다. X-ray에서 어두운 원형 음영이 보이면 바로 불량처럼 느껴지지만, 실제 판정은 그렇게 단순하지 않습니다. 중요한 것은 보이드의 절대 면적만이 아니라 어느 볼에 생겼는지, 열 경로에 걸렸는지, 한 개에 집중됐는지, 여러 개로 분산됐는지, 고객 스펙이 무엇인지입니다. 같은 0.8mm pitch BGA라도 전원 볼, 접지 볼, 고전류 열 방출 볼, 일반 신호 볼의 리스크는 같지 않습니다.
한국 고객이 BGA 실장, X-ray 검사, SMT 조립, 시제품 PCBA를 함께 문의할 때 가장 많이 묻는 질문도 비슷합니다. “보이드가 몇 퍼센트면 불량인가요?”입니다. 그러나 현장에서는 단일 숫자보다 공정 원인과 사용 조건을 함께 보아야 재작업 남용도 막고, 잠복 열 신뢰성 문제도 놓치지 않을 수 있습니다.
배경 개념은 ball grid array, reflow soldering, X-ray computed tomography, IPC electronics standards 자료를 함께 보면 이해가 빠릅니다. 이 글은 규격 문장을 그대로 옮기기보다, RFQ와 NPI, 양산 승인 회의에서 어떤 기준으로 판단해야 하는지 실무 언어로 정리합니다.

“BGA 보이드는 숫자 하나로 합격과 불합격을 자를 수 있는 문제가 아닙니다. 제가 현장에서 먼저 보는 것은 25%냐 30%냐보다 그 보이드가 전원 볼에 몰렸는지, 중앙 thermal pad와 연결됐는지, 그리고 같은 패턴이 로트 전체에서 반복되는지입니다.”
— Hommer Zhao, 창립자 & 기술 전문가
BGA 보이드란 무엇이고 왜 생기는가
BGA 보이드는 리플로우 후 솔더 조인트 내부에 남는 빈 공간입니다. 대부분은 플럭스 휘발, 패드 표면 상태, 솔더 페이스트 체적, 산화, 리플로우 프로파일, 패드 배기 경로 부족 같은 원인으로 생깁니다. 따라서 보이드는 검사 단계에서 발견되지만, 실제 원인은 대개 인쇄와 실장, 리플로우 준비 단계에 있습니다.
중요한 점은 모든 보이드가 동일한 리스크를 갖지 않는다는 사실입니다. 예를 들어 일반 신호 볼에서 작은 분산 보이드가 있는 경우와, 고전류 path나 방열용 center pad 근처에 큰 집중 보이드가 있는 경우의 위험도는 다릅니다. 특히 전력 반도체, CPU, FPGA, 통신 모듈처럼 열 밀도가 높은 제품은 단순 외관 합격보다 X-ray 해석과 열 경로 해석이 더 중요해집니다.
| 원인 영역 | 대표 메커니즘 | X-ray에서 보이는 패턴 | 실무 대응 |
|---|---|---|---|
| 스텐실 설계 | 페이스트 체적 과다, 개구 패턴 부적합 | 특정 볼 군집에서 반복적인 큰 보이드 | 스텐실 aperture와 step 여부 재검토 |
| 페이스트 관리 | 점도 변화, 냉장 해동 불량, 사용시간 초과 | 로트별 편차가 큼 | 개봉 시간, 교반 조건, 점도 추적 |
| 패드 표면 | 산화, 오염, finish 불균일 | 한 보드 안에서 위치별 불균일 | 표면처리와 세정 조건 확인 |
| 리플로우 프로파일 | soak 부족, TAL 과소/과다, peak 불안정 | 전체 패키지에 유사한 크기의 보이드 반복 | 프로파일 창 재설정, 질소 여부 검토 |
| PCB 설계 | via-in-pad, solder mask, thermal pad 분할 불량 | 특정 land pattern에서 지속 발생 | via-in-pad와 pad segmentation 재검토 |
| 부품 보관 | MSL 관리 실패, 패키지 흡습 | head-in-pillow와 혼합 의심 패턴 | MSL 관리와 베이킹 조건 점검 |
“몇 퍼센트면 불량인가”보다 먼저 봐야 할 것
많은 고객이 단일 threshold를 원하지만, 실제 승인 문서는 제품군별로 다릅니다. 어떤 팀은 단일 볼 보이드 비율을 25% 또는 30% 수준에서 관리하고, 어떤 팀은 center thermal pad만 별도 기준을 둡니다. 또 자동차, 의료, 산업 제어처럼 열 사이클과 진동 환경이 강한 제품은 같은 면적 비율이라도 더 보수적으로 판단합니다. 따라서 올바른 질문은 “정답 숫자가 무엇인가”가 아니라 “이 제품의 기능과 고객 스펙이 무엇을 요구하는가”입니다.
특히 의료용 PCB 조립, 검사 중심 양산, turnkey assembly에서는 설계 단계부터 acceptance criteria를 구매 사양서와 drawing note에 적어 두는 편이 안전합니다. 그렇게 해야 NPI 1차 로트에서 “공장은 합격이라는데 고객은 왜 NG라고 하느냐” 같은 해석 충돌을 줄일 수 있습니다.
“보이드 판정의 핵심은 검사팀이 아니라 사양 정의 단계에 있습니다. IPC-A-610을 참고하더라도 최종 승인선은 제품 열 설계와 고객 drawing note가 정합니다. 그 문장이 비어 있으면, X-ray 한 장을 두고 구매팀과 품질팀이 서로 다른 숫자를 말하게 됩니다.”
— Hommer Zhao, 창립자 & 기술 전문가
X-ray 판정에서 실제로 체크해야 하는 항목
현장에서 X-ray 이미지를 볼 때는 단순 면적 비율 외에도 네 가지를 같이 봐야 합니다. 첫째는 위치입니다. 코너 볼인지, 중앙 전원 볼인지, thermal slug와 연결된 영역인지에 따라 영향이 다릅니다. 둘째는 분포입니다. 작은 보이드가 여러 개로 분산된 경우와 큰 보이드 한 개가 중심을 차지한 경우의 해석이 다릅니다.
셋째는 반복성입니다. 같은 패키지에서 10장 중 1장만 나타난다면 우발적 편차일 수 있지만, 10장 중 8장에서 같은 위치에 반복되면 land pattern이나 profile 문제일 가능성이 높습니다. 넷째는 동반 결함입니다. 보이드가 head-in-pillow, non-wet, bridge, opens와 같이 나타나는지 보면 단순 수축공인지 공정 불안정의 징후인지 판단이 쉬워집니다.
| 판정 항목 | 낮은 리스크 신호 | 높은 리스크 신호 | 권장 액션 |
|---|---|---|---|
| 위치 | 일반 신호 볼, 비핵심 열 경로 | 전원/접지 집중 볼, thermal pad 인접 | 전류와 열 경로 문맥으로 재판정 |
| 형상 | 작고 분산된 원형 void | 큰 편심형, 서로 연결된 void | 스텐실 체적과 탈기 경로 점검 |
| 반복성 | 샘플 일부에서만 발생 | 같은 볼 위치에 로트 반복 | 설계 또는 프로파일 원인 분석 |
| 동반 결함 | 보이드 외 결함 없음 | HiP, non-wet, bridge 동반 | 보이드보다 공정 안정성 이슈로 취급 |
| 제품 용도 | 저전력 일반 디지털 | 고전력, 자동차, 의료, 열충격 환경 | 고객 특수 기준 우선 적용 |
보이드가 커지는 대표 공정 원인
첫 번째는 솔더 페이스트 체적 과다입니다. BGA 아래 중앙 패드나 BTC thermal pad에서 체적을 너무 많이 주면 휘발 성분이 빠져나갈 경로가 부족해 보이드가 커질 수 있습니다. 두 번째는 soak 구간이 짧거나 peak 상승이 급한 프로파일입니다. 기체가 빠져나가기 전에 솔더가 먼저 닫혀 버리면 내부 공극이 고정됩니다.
세 번째는 pad finish와 오염 문제입니다. ENIG 표면이라도 보관과 취급이 나쁘면 wetting이 흔들릴 수 있고, 네 번째는 via-in-pad 처리 불량입니다. filled and capped 상태가 안정적이지 않으면 솔더가 via 방향으로 끌리며 조인트 형상이 불안정해질 수 있습니다. 다섯 번째는 부품 흡습과 warpage입니다. 이런 항목은 부품 승인,스택업,다른 납땜 공정과의 열 예산까지 연결해서 봐야 정확합니다.
“보이드 개선을 위해 현장에서 가장 먼저 해볼 수 있는 것은 X-ray 기준표를 바꾸는 것이 아니라, 스텐실 개구와 리플로우 soak 시간을 함께 만져 보는 일입니다. 저는 NPI에서 3개 변수만 바꿔도 void 패턴이 10장 안에 어떻게 이동하는지 반드시 비교합니다.”
— Hommer Zhao, 창립자 & 기술 전문가
언제 리워크를 검토하고, 언제 공정 수정이 우선인가
모든 보이드에 리워크를 걸면 오히려 수율과 신뢰성이 더 나빠질 수 있습니다. BGA 재작업은 추가 열 이력, 패드 손상, warpage, 인접 부품 리스크를 동반하기 때문입니다. 따라서 1개 보드의 경계선상 void를 보고 바로 리워크하기보다, 먼저 샘플 수량을 넓혀 반복성과 기능 리스크를 확인하는 편이 낫습니다.
반대로 전원·접지 핵심 볼에 집중된 대형 void가 반복되거나, 기능 시험과 열화상에서 hotspot이 같이 보인다면 공정 수정과 리워크를 병행해야 합니다. 시제품 단계라면 stencil aperture split, soak 60~120초 조정, TAL 재조정, 질소 리플로우, thermal pad windowpane 패턴 검토가 우선입니다. 양산 단계라면 전기 테스트와 X-ray 샘플링 plan을 함께 재설정해야 합니다.
NPI와 양산에서 BGA void 전략은 다르게 가야 한다
NPI에서는 원인 규명이 우선입니다. 5장, 10장 수준의 시편이라면 판정선을 너무 빨리 고정하기보다 공정 변수 A/B test를 돌려 패턴을 보는 것이 낫습니다. 예를 들어 동일 보드에서 스텐실 개구를 80%와 65%로 나누고, soak 시간만 20초 차이로 비교하면 어느 변수가 보이드에 더 민감한지 빠르게 읽을 수 있습니다.
양산에서는 승인 속도와 일관성이 더 중요합니다. 이 단계에서는 검사자가 바뀌어도 같은 결론이 나와야 하므로, X-ray work instruction에 예시 이미지와 허용/보류/NG 정의를 넣는 편이 좋습니다. 특히 외주 PCB assembly나 다공장 운영에서는 이 문서화 수준이 수율 편차를 크게 줄여 줍니다.
RFQ와 DFM 단계에서 미리 적어 두면 좋은 체크포인트
BGA 관련 이슈를 줄이려면 제조 시작 전에 몇 가지를 명확히 적어 두는 것이 좋습니다. 최소한 패키지 pitch, ball alloy, underfill 여부, thermal pad 구조, via-in-pad 처리 방식, X-ray 검사 범위, 그리고 고객 acceptance rule 출처를 밝혀야 합니다. “IPC 기준 적용” 같은 짧은 표현만으로는 실제 해석이 엇갈릴 수 있습니다.
또한 BGA만 따로 떼어 보지 말고 스텐실,PCB 제조 공차,부품 소싱까지 하나의 패키지로 보는 편이 낫습니다. BGA 보이드 문제의 절반 이상은 검사 단계보다 upstream에서 이미 결정되기 때문입니다.
자주 묻는 질문
BGA 보이드는 무조건 불량인가요?
아닙니다. 일반적으로 IPC-A-610 참고와 고객 스펙을 함께 보며, 단일 ball의 면적 비율만으로 자동 NG를 결정하지 않는 경우가 많습니다. 다만 전원 볼, 접지 볼, thermal pad 관련 조인트는 1개의 큰 보이드도 기능과 열저항에 영향을 줄 수 있어 더 보수적으로 봐야 합니다.
X-ray에서 보이드가 20~30%로 보이면 바로 리워크해야 하나요?
바로 그렇다고 보기는 어렵습니다. 20%, 25%, 30% 같은 숫자는 내부 기준선으로 자주 쓰이지만, 실제 결정은 패키지 종류, 전력 밀도, 반복성, 고객 도면 요구사항에 따라 달라집니다. 동일 위치에 10장 중 8장 이상 반복된다면 리워크보다 공정 수정이 더 우선일 수 있습니다.
BGA 보이드를 줄이려면 가장 먼저 무엇을 조정해야 하나요?
보통은 스텐실 aperture 패턴과 리플로우 프로파일을 먼저 봅니다. 특히 center pad나 BTC 계열은 windowpane 분할과 paste area 50~80% 조정만으로도 큰 차이가 납니다. 그다음이 paste 관리, MSL, via-in-pad 품질 순서입니다.
2D X-ray만으로 충분한가요?
많은 프로젝트는 2D X-ray로 충분하지만, 0.4mm 이하 fine-pitch BGA나 다층 중첩 구조, 원인 분석이 필요한 경우에는 3D CT 또는 단면 분석이 더 유효합니다. 양산 승인 단계에서는 2D를 기본으로 두고, 분쟁 샘플만 3D로 escalate하는 방식이 비용 효율적입니다.
시제품 단계에서도 acceptance criteria를 문서화해야 하나요?
반드시 그렇습니다. 시제품 5장만 만드는 프로젝트라도 “고객 기준 없음, IPC-A-610 참고, 전원 볼은 별도 review”처럼 1줄이라도 적어 두는 편이 좋습니다. 이 문장이 없으면 Rev.A와 Rev.B 사이에 같은 X-ray 이미지를 두고 판정이 달라질 수 있습니다.
결론: 보이드 수치보다 원인과 맥락을 먼저 고정해야 한다
BGA 보이드는 SMT 현장에서 피할 수 없는 주제이지만, 그 자체로 공포의 신호일 필요는 없습니다. 중요한 것은 위치, 분포, 반복성, 제품 용도, 고객 기준을 함께 보는 것입니다. 이 다섯 가지를 정리하지 않은 채 숫자만 좇으면 불필요한 리워크로 비용이 늘고, 반대로 실제 위험한 열 경로 문제를 놓칠 수도 있습니다.
WellPCB Korea는 BGA assembly, X-ray 검사, 기능·전기 테스트, 스텐실 최적화를 함께 묶어 void 원인과 판정 기준을 정리할 수 있습니다. BGA 보이드 이슈가 있는 프로젝트라면 문의 페이지에서 Gerber, BGA package 정보, X-ray 샘플 이미지를 보내 주시면 DFM과 공정 대응 방향을 함께 검토할 수 있습니다.
Hommer Zhao
창립자 & 기술 전문가
20년 이상의 PCB 및 전자 제조 경험을 보유한 WellPCB의 창립자입니다. 글로벌 고객에게 최적의 EMS 솔루션을 제공하기 위해 기술과 품질에 대한 깊은 통찰력을 공유합니다.
관련 글

MSL PCB Assembly 가이드: 베이킹, 개봉 시간, 리플로우 리스크 관리
MSL은 PCB assembly 수율과 신뢰성을 지키는 핵심 관리 체계입니다. 이 글은 JEDEC 기준의 moisture sensitivity level, floor life, 베이킹, 개봉 시간 관리 포인트를 실무 관점에서 정리합니다.
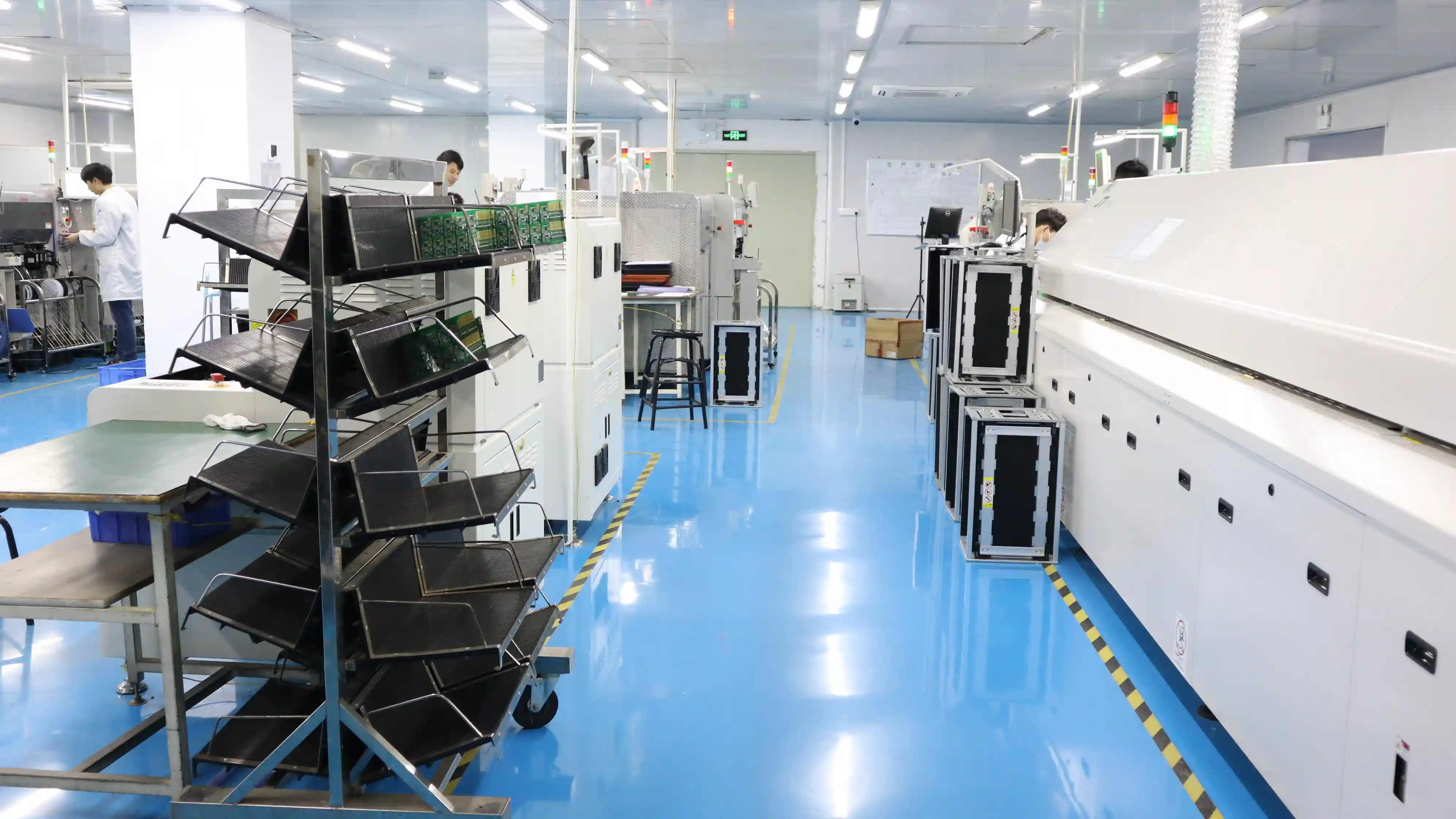
SMT 스텐실 설계 가이드: 두께, aperture, step stencil을 어떻게 결정해야 수율이 올라갈까
SMT 스텐실은 solder paste transfer와 first pass yield를 좌우하는 핵심 tooling입니다. 이 글은 두께, area ratio, aperture 설계, step stencil 적용 기준을 PCB assembly 실무 관점에서 정리합니다.

AOI vs X-Ray PCB 검사 가이드: 어떤 결함을 어디까지 잡고, 언제 함께 써야 할까
AOI와 X-Ray는 PCB assembly 품질을 높이는 핵심 검사 장비지만 보는 결함과 경제성이 다릅니다. 이 글은 SMT·BGA·QFN·THT 혼합 제품에서 어떤 결함을 어느 단계에서 잡아야 하는지, NPI와 양산에서 두 장비를 어떻게 조합해야 하는지 정리합니다.
프로젝트를 시작할 준비가 되셨나요?
전문 엔지니어 팀이 귀사의 요구사항에 맞는 최적의 솔루션을 제안해 드립니다. 지금 바로 무료 견적을 받아보세요.