BGA 조립 서비스
BGA 실장 (Ball Grid Array)
0.3mm 피치 BGA부터 uBGA, PoP, WLCSP까지 모든 BGA 패키지를 정밀 실장합니다. X-ray 전수 검사, BGA 리워크·리볼링까지 원스톱 BGA 솔루션을 제공합니다.
BGA 실장, 고성능 전자 제품의 핵심 공정
BGA 실장(Ball Grid Array Assembly)은 반도체 패키지 하면에 배열된 수백~수천 개의 솔더 볼을 통해 IC를 PCB에 접합하는 고밀도 표면실장 기술입니다. 기존의 QFP(Quad Flat Package) 대비 I/O 밀도가 높고, 전기적 특성이 우수하며, 열 방출 효율이 뛰어나 고성능 프로세서, FPGA, 메모리, 통신 IC 등 첨단 반도체의 실장에 필수적인 기술입니다.
그러나 BGA는 솔더 조인트가 패키지 아래에 숨겨져 있어 육안 검사가 불가능하고, 미세 피치 BGA의 경우 실장 난이도가 매우 높습니다. 보이드(void), 브리지, 헤드인필로우(HiP) 등의 결함은 X-ray 검사로만 검출이 가능하기 때문에, BGA 실장에는 전문 장비와 풍부한 경험을 갖춘 EMS 파트너가 필수입니다.
WellPCB Korea는 20년 이상의 BGA 실장 경험을 보유하고 있으며, 0.3mm 피치 BGA부터 uBGA, PoP, WLCSP까지 모든 유형의 BGA 패키지를 안정적으로 처리합니다. 5μm 해상도의 X-ray 전수 검사, 전문 BGA 리워크·리볼링 서비스, 그리고 무료 DFM 설계 검토까지 BGA 실장에 필요한 모든 것을 원스톱으로 제공합니다.
SMT 조립과 함께 BGA 실장을 의뢰하시면 공정 효율이 극대화되며, PCB 기판 제조부터 BGA 실장, 턴키 어셈블리까지 원스톱 서비스로 리드타임과 비용을 절감할 수 있습니다.

BGA 기술
왜 WellPCB의 BGA 실장인가?
BGA 실장은 단순한 부품 배치가 아닙니다. 솔더 페이스트 도포량, 리플로우 온도 프로파일, PCB와 BGA 간의 CTE(열팽창계수) 매칭, 그리고 정밀한 X-ray 검사까지 모든 요소가 완벽하게 조화되어야 신뢰성 높은 BGA 솔더 조인트를 형성할 수 있습니다.
WellPCB는 20년간 축적한 BGA 실장 노하우와 최첨단 장비를 결합하여 50 DPMO 미만의 업계 최고 수준 품질을 달성합니다.
- ✓0.3mm 피치 BGA부터 PoP, WLCSP까지 대응
- ✓5μm 해상도 X-ray 전수 검사 체계
- ✓전문 BGA 리워크 & 리볼링 서비스
- ✓무료 DFM 설계 검토 & BGA 공정 최적화
- ✓ISO 9001, IATF 16949 인증 공장
BGA 가공 역량
BGA 실장 핵심 역량
최첨단 장비와 20년 경험의 공정 엔지니어가 만드는 고신뢰성 BGA 솔루션
초미세 피치 BGA 실장
0.3mm 피치 BGA까지 정밀 실장이 가능합니다. 최신 비전 정렬 시스템으로 ±25μm 이내의 배치 정확도를 보장하며, uBGA, WLCSP 등 첨단 패키지에 대응합니다.
PoP (Package on Package)
PoP(Package on Package) 실장은 하부 로직 BGA 위에 상부 메모리 BGA를 적층하는 기술입니다. 스마트폰, IoT 디바이스에 필수인 PoP 실장을 안정적으로 수행합니다.
X-ray 전수 검사
5μm 해상도의 2D/3D X-ray 장비로 모든 BGA 솔더 조인트를 전수 검사합니다. 보이드(void) 비율, 브리지, 오픈, HiP 등 육안으로 확인 불가능한 결함을 100% 검출합니다.
BGA 리워크 전문
IR 하이브리드 BGA 리워크 스테이션으로 불량 BGA를 안전하게 제거·교체합니다. 주변 부품 손상 없이 정확한 온도 프로파일로 리워크하며, X-ray로 재검사합니다.
BGA 리볼링 서비스
솔더 볼이 손상되거나 산화된 BGA의 리볼링(reballing) 서비스를 제공합니다. 레이저 커팅 스텐실로 정확한 크기와 합금 조성의 솔더 볼을 재형성합니다.
질소 분위기 리플로우
10존 질소 분위기 리플로우 오븐에서 BGA 특성에 맞는 최적의 온도 프로파일로 솔더링합니다. 질소 환경으로 산화를 방지하고 보이드 발생률을 최소화합니다.
언더필(Underfill) 공정
고신뢰성이 요구되는 BGA에 캐필러리 언더필 또는 몰디드 언더필을 적용합니다. 열충격, 진동, 낙하 충격에 대한 솔더 조인트 내구성을 대폭 향상시킵니다.
DFM 설계 검토
BGA 실장 전 무료 DFM(Design for Manufacturing) 검토를 실시합니다. 패드 설계, 비아-인-패드, 솔더 마스크 개구부, PCB 스택업 등을 최적화하여 실장 수율을 극대화합니다.
BGA 단면 분석
품질 검증이 필요한 경우 BGA 솔더 조인트의 단면(Cross-section) 분석을 수행합니다. IMC(금속간화합물) 두께, 보이드 분포, 크랙 유무를 정밀하게 확인합니다.
BGA 종류
대응 가능한 BGA 패키지 유형
표준 PBGA부터 초미세 WLCSP까지, 모든 BGA 패키지 유형을 실장합니다
PBGA (Plastic BGA)
1.0 ~ 1.27mm가장 일반적인 BGA 유형. 1.0~1.27mm 피치. FPGA, DSP, 네트워크 프로세서 등에 사용.
uBGA (Micro BGA)
0.4 ~ 0.65mm소형 고밀도 패키지. 0.4~0.65mm 피치. 모바일 AP, 베이스밴드 칩에 적용.
CSP (Chip Scale Package)
0.3 ~ 0.5mm칩 크기에 가까운 초소형 패키지. 0.3~0.5mm 피치. 메모리, 센서 IC에 사용.
PoP (Package on Package)
0.4 ~ 0.5mm로직 BGA 위에 메모리 BGA를 적층. 스마트폰 AP+DRAM 구조에 필수.
FCBGA (Flip Chip BGA)
0.8 ~ 1.0mm플립칩 다이를 기판에 직접 접합. 고성능 CPU, GPU에 사용. 높은 I/O 밀도.
WLCSP (Wafer Level CSP)
0.3 ~ 0.4mm웨이퍼 레벨에서 패키징. 0.3~0.4mm 피치. 초소형 아날로그 IC, PMIC에 적용.
사양
BGA 실장 기술 사양
업계 최고 수준의 BGA 실장 능력으로 가장 까다로운 프로젝트에 대응합니다
BGA 공정
BGA 실장 공정 흐름
DFM 설계 검토부터 X-ray 전수 검사까지, 단계별 품질 관리 체계
거버 파일 & BOM 접수 / DFM 검토
고객의 PCB 설계 데이터와 BOM을 접수합니다. BGA 패드 설계, 비아-인-패드 처리, 솔더 마스크 개구부 등 BGA 실장에 영향을 미치는 요소를 무료로 DFM 검토하고 최적화 방안을 제안합니다.
스텐실 제작 & 솔더 페이스트 인쇄
BGA 패드 크기와 피치에 최적화된 레이저 커팅 스텐실을 제작합니다. 스텐실 개구부 비율(area ratio), 두께, 형상을 BGA 특성에 맞게 설계하여 적정량의 솔더 페이스트를 인쇄합니다. 3D SPI로 인쇄 품질을 즉시 검증합니다.
BGA 정밀 배치 (Pick & Place)
고정밀 픽앤플레이스 장비가 비전 카메라로 BGA의 솔더 볼 패턴을 인식하고, PCB 패드 위에 정확히 배치합니다. 코플래너리티(coplanarity) 검사로 BGA 평탄도를 확인하여 솔더링 불량을 예방합니다.
리플로우 솔더링 (N₂ 분위기)
10존 질소 분위기 리플로우 오븐에서 BGA 사양에 맞는 온도 프로파일로 솔더링합니다. 열용량이 큰 BGA의 특성을 고려한 프리히트, 소크, 리플로우, 냉각 단계를 정밀하게 제어합니다.
X-ray 전수 검사
BGA 솔더 조인트는 육안 검사가 불가능하므로, 5μm 해상도의 X-ray 장비로 모든 BGA를 전수 검사합니다. 보이드 비율, 브리지, 오픈, 미스얼라인먼트, 헤드인필로우(HiP) 등 결함 유무를 확인합니다.
기능 테스트 & 출하
ICT(인서킷 테스트)와 FCT(기능 테스트)로 BGA 접합부의 전기적 연결과 기능을 최종 검증합니다. 필요 시 언더필 공정을 추가하여 솔더 조인트 내구성을 강화한 후, 정전기 방지 포장으로 안전하게 납품합니다.
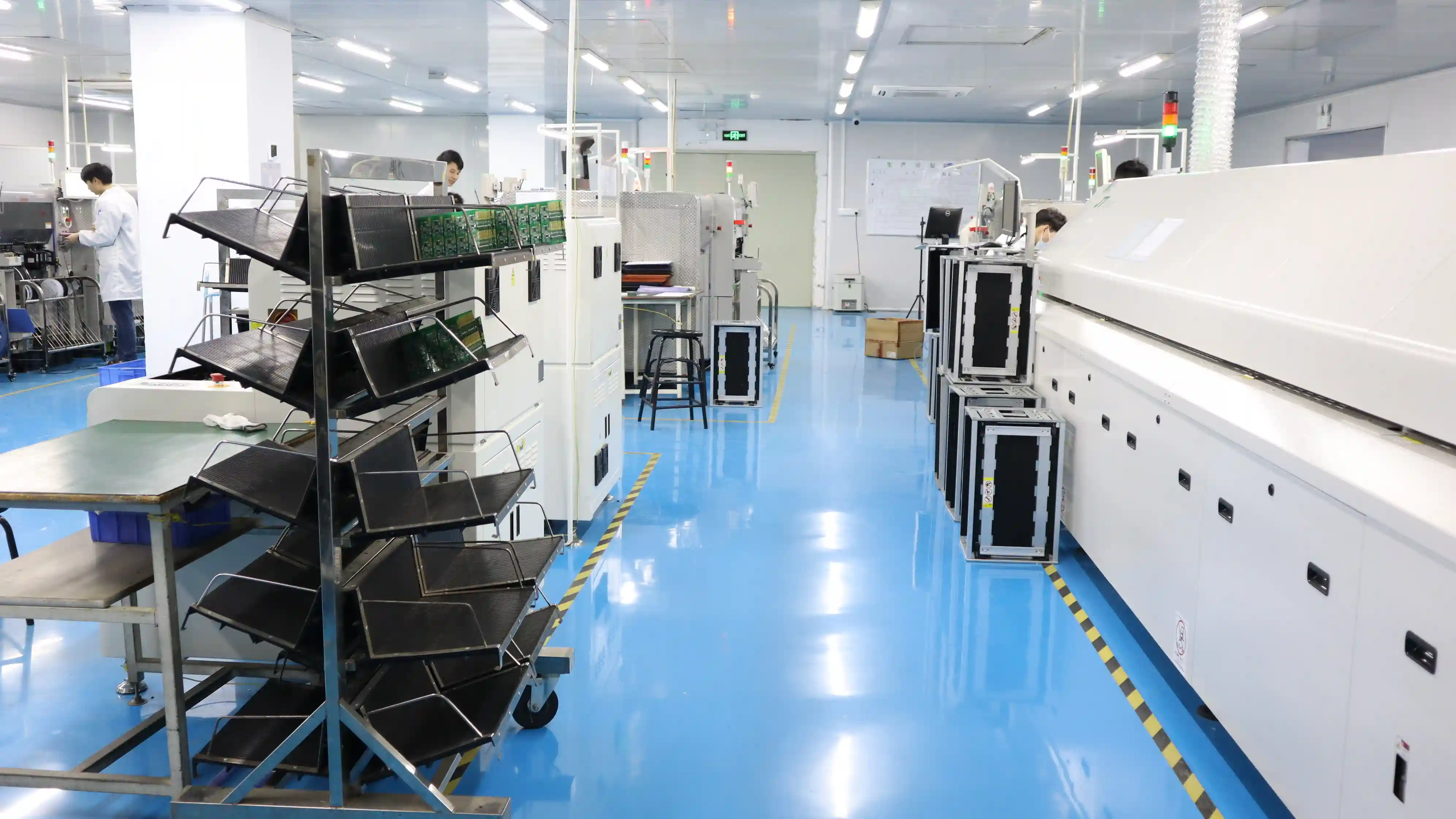
"BGA 실장에서 가장 중요한 것은 보이지 않는 솔더 조인트의 품질입니다. 우리는 모든 BGA에 X-ray 전수 검사를 실시하고, 보이드 비율, 브리지, HiP 등의 결함을 0.001mm 단위까지 분석합니다. 또한 리플로우 프로파일을 BGA 패키지별로 개별 최적화하여 보이드 발생을 최소화합니다. 이것이 20년 경험에서 나오는 차별화입니다."
Hommer Zhao
창립자 & 기술 전문가
비교
BGA vs QFP: 왜 BGA를 선택하는가?
| 비교 항목 | BGA | QFP |
|---|---|---|
| I/O 핀 수 | 수백~수천 개 | 최대 256개 |
| 최소 피치 | 0.3mm | 0.4mm |
| 전기적 성능 | 짧은 리드로 우수 | 긴 리드로 인덕턴스 증가 |
| 열 방출 | 넓은 접촉면으로 우수 | 제한적 |
| 기판 면적 | 패키지 하면 활용으로 작음 | 주변 핀으로 넓음 |
| 자기 정렬 | 솔더 볼 표면장력으로 자동 정렬 | 정렬 오차 민감 |
| 검사 방법 | X-ray 필수 | 육안/AOI 가능 |
| 리워크 난이도 | 전문 장비 필요 | 비교적 용이 |
BGA는 I/O 밀도, 전기적 성능, 열 방출 모든 면에서 QFP보다 우수하지만, X-ray 검사와 전문 리워크 장비가 필수적입니다. WellPCB는 이 모든 역량을 갖추고 있습니다.
응용 분야
BGA 실장 적용 분야
고성능 프로세서, FPGA, 메모리 등 BGA 패키지가 사용되는 모든 산업 분야에 대응합니다
스마트폰 & 모바일
모바일 AP, 베이스밴드, PoP 메모리, PMIC 실장
서버 & 네트워크
CPU, GPU, FPGA, 네트워크 스위치 IC BGA 실장
자동차 전장
ADAS 프로세서, ECU, 인포테인먼트 SoC BGA 실장
의료 전자
진단 장비, 이미징 시스템, 환자 모니터 BGA 실장
통신 & 5G
5G 기지국 모듈, 라우터, 광통신 장비 BGA 실장
항공우주 & 방산
레이더, 위성 통신, 항법 시스템 고신뢰성 BGA 실장
소비자 전자
게임 콘솔, TV, 디스플레이 컨트롤러 BGA 실장
산업 자동화
PLC, 모터 드라이버, 비전 시스템 FPGA BGA 실장
품질 보증
BGA 실장 품질 보증
BGA 솔더 조인트는 패키지 아래에 숨겨져 있어 X-ray 검사가 유일한 비파괴 검사 방법입니다. WellPCB는 5μm 해상도의 X-ray 장비로 모든 BGA를 전수 검사하며, IPC-7095 기준에 따라 보이드 비율 25% 미만을 관리합니다.
ISO 9001, IATF 16949, ISO 13485 인증을 보유한 공장에서 생산하므로, 자동차 전장, 의료기기 등 높은 신뢰성이 요구되는 분야의 BGA 실장도 안심하고 맡기실 수 있습니다. 필요 시 단면 분석(Cross-section)과 열충격 테스트(Thermal Cycling)로 BGA 솔더 조인트의 장기 신뢰성을 검증합니다.

"BGA 리워크는 단순히 부품을 떼고 붙이는 작업이 아닙니다. PCB 패드 손상 없이 BGA를 제거하고, 잔여 솔더를 완벽히 클리닝한 후, 새 BGA를 정확한 온도 프로파일로 재실장해야 합니다. 우리는 IR 하이브리드 리워크 스테이션과 X-ray 검증을 통해 리워크 품질도 신규 실장과 동일한 수준으로 보장합니다."
Hommer Zhao
창립자 & 기술 전문가
BGA 결함
BGA 실장 주요 결함과 방지 대책
BGA 실장에서 발생할 수 있는 결함과 WellPCB의 예방 전략
보이드 (Void)
원인: 솔더 페이스트 내 플럭스 가스 잔류, 부적절한 리플로우 프로파일
방지: 질소 분위기 리플로우, 최적 프로파일 설정, SPI 관리
브리지 (Bridge)
원인: 과잉 솔더 페이스트, BGA 코플래너리티 불량
방지: 스텐실 개구부 최적화, 코플래너리티 사전 검사
헤드인필로우 (HiP)
원인: 솔더 페이스트 내 가스가 솔더 볼 내부로 유입
방지: 프리히트 구간 최적화, 저잔사 플럭스 사용
오픈 (Open)
원인: PCB 워피지, 솔더 페이스트 부족, 열 불균일
방지: PCB 프리베이킹, 스텐실 관리, 열 프로파일 최적화
미스얼라인먼트
원인: 픽앤플레이스 정밀도 부족, PCB 또는 BGA 마킹 오류
방지: 비전 정렬 시스템, 정기적 장비 캘리브레이션
크랙 (Crack)
원인: 열충격, 기계적 스트레스, CTE 불일치
방지: 언더필 적용, 적절한 냉각 속도, PCB 스택업 최적화
자주 묻는 질문
BGA 실장 자주 묻는 질문
BGA 실장이란 무엇인가요?
BGA(Ball Grid Array) 실장은 패키지 하면에 배열된 솔더 볼을 통해 IC를 PCB에 접합하는 고밀도 표면실장 기술입니다. 솔더 페이스트 인쇄, 픽앤플레이스 장비를 통한 정밀 배치, 리플로우 솔더링의 3단계로 구성됩니다. 기존 QFP 대비 I/O 밀도가 높고, 전기적 특성이 우수하며, 열 방출 효율이 좋아 고성능 프로세서, FPGA, 메모리 등에 널리 사용됩니다.
BGA 실장 가능한 최소 피치는 얼마인가요?
WellPCB의 BGA 실장 라인은 0.3mm 피치까지 대응 가능합니다. uBGA(0.4mm 피치), CSP(Chip Scale Package), PoP(Package on Package), WLCSP(Wafer Level CSP) 등 최신 미세 피치 BGA 패키지를 안정적으로 처리합니다. 비전 정렬 시스템으로 ±25μm 이내의 배치 정확도를 보장합니다.
BGA 실장 품질은 어떻게 검사하나요?
BGA는 솔더 조인트가 패키지 아래에 숨겨져 있어 육안 검사가 불가능합니다. WellPCB는 5μm 해상도의 X-ray 검사 장비로 BGA 솔더 조인트를 전수 검사합니다. 보이드(void) 비율, 브리지, 오픈, 헤드인필로우(HiP) 등의 결함을 정밀하게 검출합니다. 필요시 단면 분석(Cross-section)도 실시합니다.
BGA 리워크(재작업)가 가능한가요?
네, WellPCB는 전문 BGA 리워크 서비스를 제공합니다. IR 하이브리드 BGA 리워크 스테이션으로 불량 BGA를 안전하게 제거하고, 패드 클리닝 후 새 BGA를 재실장합니다. 리볼링(reballing) 서비스도 제공하여 솔더 볼이 손상된 BGA를 복원할 수 있습니다. 리워크 후에도 X-ray 검사로 품질을 확인합니다.
BGA 실장 비용은 어떻게 산정되나요?
BGA 실장 비용은 BGA 유형(표준 BGA, uBGA, PoP 등), 피치 크기, 볼 수, PCB 층수, 양면 실장 여부, 주문 수량에 따라 달라집니다. Fine-pitch BGA나 PoP 등 고난이도 패키지는 추가 비용이 발생합니다. 무료 DFM 검토와 함께 정확한 견적을 제공하니 거버 파일과 BOM을 보내주세요.
BGA 실장 시 주의해야 할 PCB 설계 포인트는?
BGA 실장을 위한 PCB 설계 시 패드 크기(NSMD vs SMD 패드), 솔더 마스크 개구부, 비아-인-패드(VIP) 처리, BGA 아래 배선 라우팅, 열 릴리프 패턴, PCB 휨(warpage) 제어가 중요합니다. WellPCB는 무료 DFM 검토를 통해 설계 단계에서 잠재적 BGA 실장 문제를 사전에 식별하고 개선안을 제안합니다.
BGA 실장 프로젝트를 시작하시겠습니까?
거버 파일과 BOM을 보내주시면 무료 DFM 검토와 함께 BGA 실장 맞춤 견적을 제공합니다. 전문 엔지니어가 24시간 내 답변드립니다.