Reflow Profile PCB Assembly 가이드: SMT 온도 프로파일을 NPI와 양산에서 어떻게 승인할까
Reflow profile은 PCBA 수율, 부품 MSL, BGA void, wetting, 열손상을 함께 관리하는 공정 승인 기준입니다. IPC-J-STD-001, IPC-A-610, JEDEC J-STD-020 관점에서 NPI와 양산 프로파일 승인법을 정리합니다.
Hommer Zhao
· 창립자 & 기술 전문가
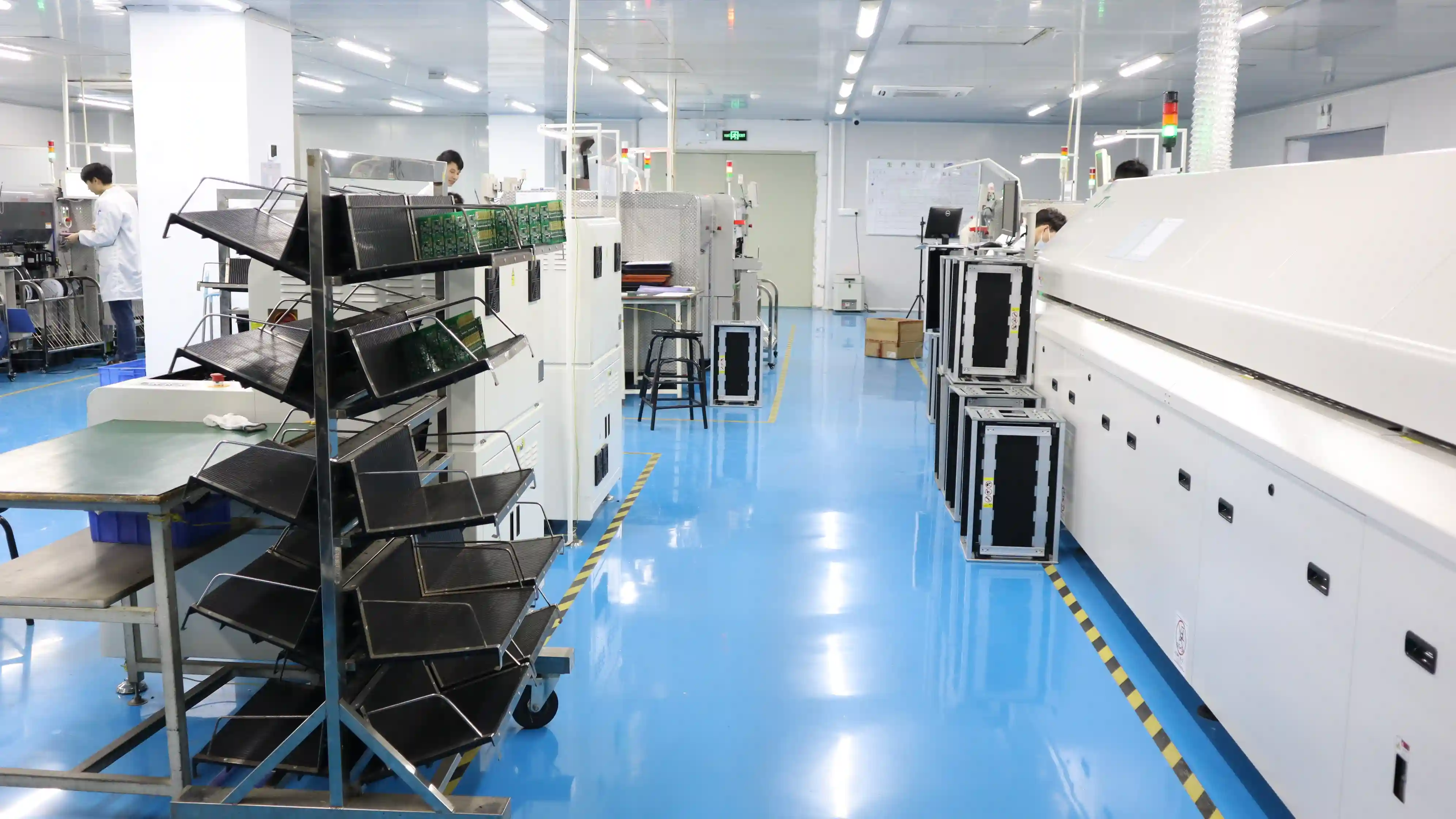
Reflow profile은 오븐 온도표 한 장으로 끝나는 문서가 아닙니다. SMT 라인에서 실제로 봐야 하는 것은 보드 위 가장 차가운 solder joint가 충분히 젖었는지, 가장 뜨거운 부품이 손상 한계 안에 있는지, flux가 너무 빨리 소진되지 않았는지, 그리고 같은 조건을 500대와 5,000대에서도 반복할 수 있는지입니다.
이 글의 독자는 이미 Gerber, BOM, CPL을 공급사에 보냈고 NPI 또는 양산 견적 단계에서 “리플로우 프로파일은 공급사가 알아서 잡겠지”라고 넘기기에는 제품 리스크가 큰 하드웨어 엔지니어와 구매팀입니다. 특히 BGA, QFN, 고전류 커넥터, 금속 하우징 근처 보드, MSL 3 이상 부품이 섞인 PCB assembly프로젝트라면 프로파일 승인 기준을 RFQ 단계에서 정해야 합니다.
표준의 역할도 분명히 나누어야 합니다. 납땜 공정 요구는 IPC의 IPC-J-STD-001, 외관 수용 판단은 IPC-A-610, 부품의 리플로우 내열 조건은 JEDECJ-STD-020과 J-STD-033을 함께 봅니다. 안전 인증 부품과 절연 재료가 얽힌 제품은 UL94 또는 UL-758 같은 재료·전선 요구도 별도로 확인합니다.
“리플로우 프로파일은 peak 240도라는 숫자보다 열전대 위치가 더 중요합니다. BGA 중앙, 큰 커넥터 근처, 보드 edge를 동시에 찍지 않으면 가장 위험한 joint를 놓칩니다.”
— Hommer Zhao, 창립자 & 기술 전문가
NPI에서 권장하는 열전대 측정 위치
SAC305 TAL 검토 범위
많은 무연 PCBA의 joint peak 검토 범위
양면 SMT에서 누적 열 이력 확인 지점
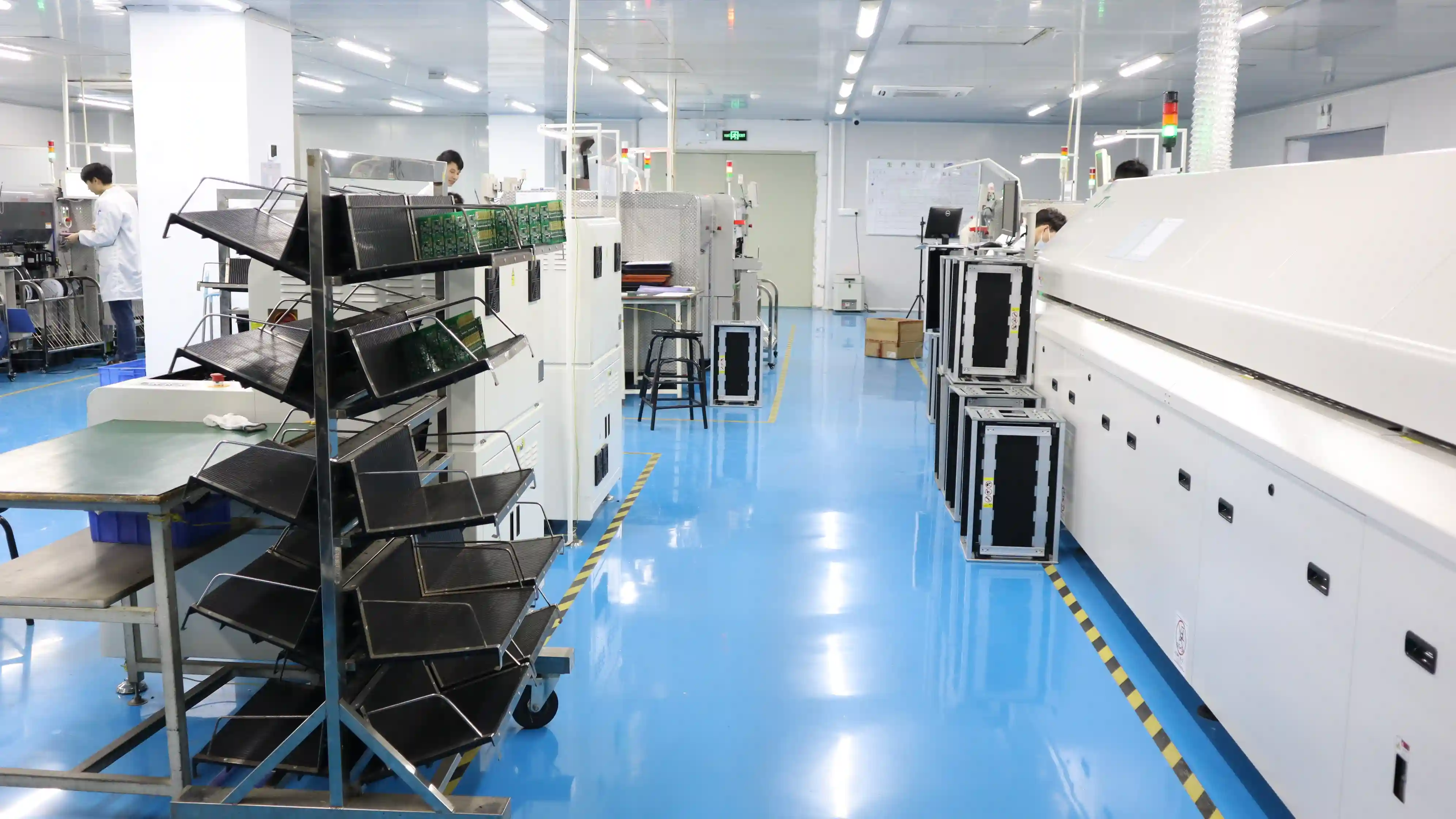
Reflow profile에서 실제로 승인해야 하는 값
공급사가 “표준 무연 프로파일입니다”라고 답하면 충분하지 않습니다. 승인 문서에는 oven zone setpoint, conveyor speed, ramp rate, soak 구간, peak temperature, time above liquidus(TAL), cooling rate, paste lot, 보드 revision, 측정 날짜가 들어가야 합니다. 그래야 다음 lot에서 불량이 생겼을 때 같은 조건이었는지 확인할 수 있습니다.
SAC305 계열 솔더는 보통 217도 이상을 liquidus 기준으로 봅니다. 하지만 TAL을 길게 잡는다고 wetting이 항상 좋아지는 것은 아닙니다. flux가 먼저 고갈되면 오히려 산화막 제거 능력이 떨어지고, 작은 칩 부품은 tombstone, 대형 패드는 void, 민감 부품은 discoloration 또는 package stress가 생길 수 있습니다.
NPI에서 겪은 실제 프로파일 승인 사례
2026년 1분기 WellPCB Korea가 검토한 산업 제어용 PCBA 1,200대 파일럿 lot에서 비슷한 문제가 있었습니다. 보드는 6층 FR4, 1.6mm 두께, 0.5mm pitch QFN 4개, 256-ball BGA 1개, 12A 전원 커넥터 2개를 포함했습니다. 첫 프로파일은 oven exit 기준 peak 242도였지만, BGA 중앙 열전대는 229도에 머물렀고 대형 커넥터 옆 QFN은 X-ray에서 35% 이상 void가 반복되었습니다.
같은 보드 10장을 버리지 않고 4-zone setpoint와 conveyor speed만 바꿔 A/B 비교를 했습니다. Soak을 82초에서 105초로 늘리고 peak setpoint를 3도 낮춘 뒤, BGA 중앙 joint peak는 236~238도까지 올라갔고 QFN thermal pad void는 샘플 평균 34%에서 18%로 내려갔습니다. 기능 시험 100%와 X-ray 샘플링 30% 기준을 통과한 뒤에야 해당 profile을 release 조건으로 잠갔습니다.
이 사례의 핵심은 수치가 멋있어서가 아니라, 측정 위치와 결함 데이터를 함께 본 점입니다. 오븐 표시 온도만 봤다면 첫 프로파일도 정상처럼 보였을 것입니다. 하지만 실제 joint 온도와 X-ray 결과를 연결하자 무엇을 바꿔야 하는지 명확해졌습니다.
“저는 프로파일 승인 때 pass/fail보다 반복성을 먼저 봅니다. 샘플 10장 중 8장에서 같은 void 위치가 나오면 운이 아니라 공정 변수입니다. 그때는 온도, aperture, via 구조를 같이 봐야 합니다.”
— Hommer Zhao, 창립자 & 기술 전문가
프로파일 유형별 판단 기준
Reflow profile은 제품마다 다르지만, 검토 관점은 몇 가지로 정리할 수 있습니다. 빠른 ramp는 산화와 cycle time에는 유리할 수 있으나 부품과 보드의 열평형이 부족해질 수 있습니다. 긴 soak은 열용량 차이를 줄이는 데 도움이 되지만 flux 활성 구간을 과하게 소모할 수 있습니다.
| 프로파일 전략 | 적합한 보드 | 확인할 숫자 | 대표 리스크 |
|---|---|---|---|
| Ramp-to-peak | 단순 SMT, 열용량 차이가 작은 보드 | Ramp 1~3도/초, TAL 45~75초 | 대형 부품 wetting 부족 |
| Soak profile | BGA, QFN, 큰 connector가 섞인 보드 | Soak 80~120초, TAL 60~90초 | Flux 고갈, 산화 증가 |
| Low peak profile | 열 민감 커넥터, LED, 플라스틱 부품 | Peak margin과 wetting 동시 확인 | Cold solder, non-wet |
| Nitrogen reflow | 미세 피치, 산화 민감 표면처리, 고신뢰 보드 | Oxygen ppm, void trend, wetting angle | 비용 증가, 효과 과대평가 |
| Double-sided profile | 양면 SMT, bottom side heavy component | 1차·2차 peak, 누적 열 이력 | 부품 낙하, MSL 초과, warpage |
IPC-J-STD-001, IPC-A-610, JEDEC를 어떻게 함께 쓰나
IPC-J-STD-001은 납땜 공정 요구와 작업 기준을 정의하는 출발점입니다. IPC-A-610은 만들어진 electronic assembly를 Class 2 또는 Class 3 관점에서 어떻게 받아들일지 판단하는 기준입니다. JEDEC J-STD-020은 부품이 견딜 수 있는 reflow peak 조건을 보고, J-STD-033은 moisture-sensitive device의 보관, bake, floor life 관리를 다룹니다.
즉, IPC 기준으로 납땜 외관이 좋아 보여도 JEDEC 조건을 넘기면 부품 신뢰성 문제가 남습니다. 반대로 부품 온도를 보수적으로 낮추다 wetting이 부족하면 IPC-A-610 수용 기준에서 불합격이 됩니다. 구매팀은 견적서에 “IPC Class 2”만 쓰지 말고, profile approval report와 MSL handling record를 함께 요구해야 합니다.
BGA와 QFN은 profile만 보지 말고 X-ray와 묶어야 한다
BGA와 QFN의 solder joint는 외관 검사만으로 충분히 볼 수 없습니다. 특히 QFN thermal pad는 전기 기능이 정상이어도 void가 열저항을 키울 수 있습니다. 그래서 reflow profile approval은 X-ray 검사와 연결해야 합니다.
NPI에서는 최소 첫 5~10장에 대해 X-ray void map을 남기고, 공정 변경 후에는 같은 위치의 이미지를 비교해야 합니다. void가 줄었는지뿐 아니라 모양이 바뀌었는지도 봅니다. 둥글고 분산된 작은 void와 한쪽으로 몰린 큰 void는 원인과 위험도가 다릅니다. 자세한 판정은 BGA 보이드와 X-Ray 판정 가이드에서 함께 확인할 수 있습니다.
MSL 부품은 프로파일 승인 전에 이미 관리가 시작된다
MSL 부품은 오븐 안에서만 문제가 생기지 않습니다. 포장을 연 뒤 floor life를 초과했거나 습도카드가 기준을 벗어난 상태라면 좋은 profile도 popcorning과 delamination을 막지 못합니다. MSL 3 이상 부품은 dry cabinet, bake record, opening time, mounting completion time을 lot record에 연결해야 합니다.
프로파일 승인 때는 부품별 maximum reflow count도 봐야 합니다. 양면 SMT, rework, selective soldering 후열까지 합치면 어떤 부품은 허용 열 이력에 가까워질 수 있습니다. 이 관점은 MSL PCB Assembly 가이드와 같이 보면 더 명확합니다.
“MSL 관리는 창고 규정이 아니라 리플로우 품질의 일부입니다. MSL 3 부품을 168시간 floor life 안에서 닫지 못하면 profile 조정으로 해결할 문제가 아닙니다.”
— Hommer Zhao, 창립자 & 기술 전문가
RFQ에 넣어야 할 Reflow Profile 승인 항목
RFQ 단계에서 profile 조건을 쓰면 공급사가 불필요하게 보수적인 견적을 낼 것 같아 걱정할 수 있습니다. 하지만 조건을 쓰지 않으면 NPI에서 더 비싼 지연이 생깁니다. 핵심은 모든 숫자를 고객이 고정하는 것이 아니라, 공급사가 어떤 데이터를 제출해야 하는지 정하는 것입니다.
- Thermocouple 위치: BGA 중앙, 대형 커넥터, board edge, 가장 작은 passive 부품 근처
- Profile data: ramp, soak, peak, TAL, cooling rate, conveyor speed, zone setpoint
- Inspection link: SPI trend, AOI 결과, X-ray sampling ratio, FCT pass 기준
- Material control: solder paste part number, paste lot, stencil thickness, MSL record
- Change control: paste, oven, board finish, stencil, component alternate 변경 시 재승인 범위
SMT 조건을 처음부터 정리하려면 SMT assembly, SMT 스텐실 설계, PCB 테스트 서비스를 한 흐름으로 묶어 보는 편이 낫습니다.
양산에서 profile을 다시 봐야 하는 변경점
한 번 승인된 profile도 영구 고정값은 아닙니다. Solder paste lot 변경, stencil thickness 변경, ENIG에서 OSP로의 표면처리 변경, BGA 공급사 변경, PCB 두께 변경, oven maintenance, conveyor speed 변경은 모두 profile 재확인 대상입니다. IATF 16949식 변경관리 관점에서는 고객 승인 필요 여부와 내부 재검증 범위를 미리 나눠야 합니다.
양산에서 가장 위험한 문장은 “지난번과 거의 같습니다”입니다. 거의 같은 보드라도 copper balance가 다르고, panel 배열이 바뀌고, 커넥터 하우징 재질이 달라지면 열 응답이 바뀝니다. 최소한 첫 생산 3~5장 profile check와 SPI/AOI/X-ray Pareto 비교는 남겨야 다음 lot의 기준점이 생깁니다.
FAQ
Reflow profile은 PCBA마다 새로 잡아야 하나요?
보드 크기, 동박 면적, BGA·QFN·대형 커넥터 조합, 부품 MSL이 달라지면 새로 검증하는 편이 안전합니다. 같은 라인이라도 첫 NPI에서는 최소 3~5개 온도 측정 지점으로 peak, soak, TAL을 확인해야 합니다.
SAC305 무연 리플로우 peak 온도는 어느 정도가 적절한가요?
많은 PCBA에서 부품 단자 기준 235~245도 범위를 검토하지만, 최종 기준은 부품 데이터시트와 JEDEC J-STD-020 허용 온도, IPC-J-STD-001 납땜 요구를 함께 봐야 합니다.
Time above liquidus는 길수록 좋은가요?
아닙니다. SAC305 계열에서는 217도 이상 TAL을 보통 45~90초 범위에서 검토하지만, 과도하면 IMC 성장, 부품 열손상, flux 고갈이 생길 수 있습니다.
BGA void가 많으면 reflow profile만 바꾸면 되나요?
프로파일은 주요 변수지만 stencil aperture, paste chemistry, via-in-pad, PCB 표면처리도 함께 봐야 합니다. NPI에서는 동일 보드 5~10장 기준으로 X-ray void map을 비교하는 방식이 유효합니다.
MSL 부품은 reflow profile 승인에서 무엇을 봐야 하나요?
MSL 3 이상 부품은 floor life, bake 기록, dry pack 상태를 profile 승인 전 확인해야 합니다. JEDEC J-STD-033 취급 기준과 J-STD-020 peak 조건을 동시에 맞추는 것이 핵심입니다.
리플로우 프로파일 승인 기록에는 무엇이 들어가야 하나요?
라인 번호, oven zone setpoint, conveyor speed, 열전대 위치 3~5곳, peak 온도, TAL, soak time, ramp rate, 사용 paste lot, 보드 revision, 승인자와 날짜를 남겨야 양산 변경관리가 가능합니다.
프로파일은 공정 언어로 잠가야 한다
Reflow profile은 생산 현장의 노하우로 남겨두면 추적할 수 없습니다. 숫자, 위치, 검사 결과, 변경관리 조건으로 남겨야 다음 lot에서도 같은 품질을 재현할 수 있습니다. WellPCB Korea는 PCB 제조, SMT, X-ray, 기능 테스트, box build를 한 흐름으로 검토해 NPI에서 양산까지 이어지는 profile approval record를 준비합니다.
BGA, QFN, MSL 부품, 고전류 커넥터가 섞인 보드라면 프로젝트 파일과 목표 수량을 보내 주세요. Gerber, BOM, CPL, assembly drawing 기준으로 어떤 열전대 위치와 검사 범위가 필요한지 먼저 검토하겠습니다.
관련 글

PCB Assembly Cost 가이드: SMT 견적을 좌우하는 12가지 핵심 변수
PCBA 견적 차이는 단가표보다 setup, BOM, SMT placement, 검사, 테스트, 리드타임 조건에서 갈립니다. 실제 800대 NPI 사례와 IPC-J-STD-001, IPC-A-610 기준으로 비용을 낮추되 신뢰성을 잃지 않는 판단법을 정리합니다.

전자 포팅 vs 컨포멀 코팅 완전 가이드: PCBA 보호 공정과 양산 검사 선택 기준
침수, 응축, 고전압, 리워크 요구가 섞인 PCBA에서 포팅과 컨포멀 코팅을 어떻게 나눌까요? IPC-J-STD-001, IPC-A-610, UL 94 기준과 85℃/85%RH 시험, FCT 100% 기준으로 선택법과 RFQ 문구를 정리합니다.

PCB Assembly 리워크 판정 기준: IPC 표준으로 재작업 한계와 승인 정하기
PCBA 리워크는 불량을 고치는 작업이지만, 반복 열 이력과 패드 손상 리스크를 숫자로 관리하지 않으면 양산 신뢰성을 해칠 수 있습니다. IPC-A-610, IPC-J-STD-001, IPC-7711/7721 관점에서 리워크 허용 기준, 승인 흐름, 공급사 감사 질문을 정리합니다.